揭秘承芯HBT工艺高可靠性的四大硬核指标
作者:承芯客户工程部—大鹏
随着5G智能手机的普及,射频前端市场迎来了需求的爆发。GaAs HBT(Heterojunction Bipolar Transistor)工艺作为手机放大器的核心制程,已经引起了越来越多人的关注和重视。根据Yole的报告,在7GHz以下的频率范围内,GaAs HBT无疑是移动终端放大器的首选。
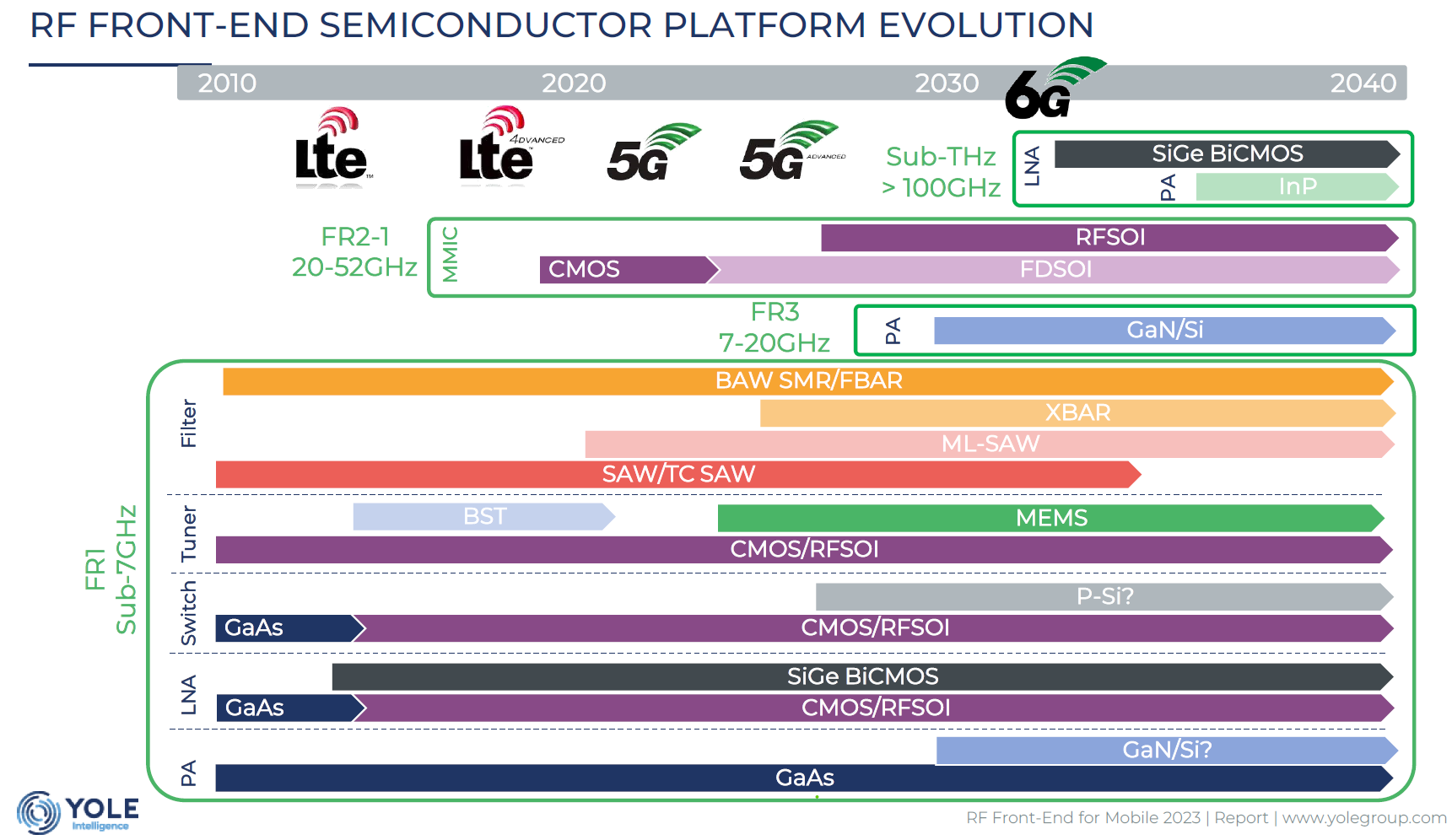
许多采用承芯HBT工艺的PA设计公司,已经通过了各类元器件级别的高可靠性验证和测试,例如RF-HTOL和bHAST等。同时,越来越多的PA fabless design house和国内知名手机公司期望承芯能够从GaAs代工厂的角度分享工艺制程相关的可靠性经验。
承芯HBT可靠性测试介绍
关于HBT wafer level可靠性,我们看看一些客户比较关注的可靠性项目:
HTOL- High Temperature Operating Life
HTOL是一种电子器件可靠性测试方法,主要用于评估器件在高温环境下的耐久性和寿命,HTOL测试可以帮助检测出在高温环境下可能出现的期间故障机制,如热失效、氧化、电迁移等。通过长时间稳定运行和持续应力测试,可以加速这些失效机制的发生,提前评估器件的可靠性,并预测其在实际使用中的寿命。
承芯HTOL测试使用标准的可靠性测试结构(2x3x20um^2),失效标准为是Beta(电流增益)在测试后降低量低于20%(参考JEP118A)。HTOL测试条件及结果如下:
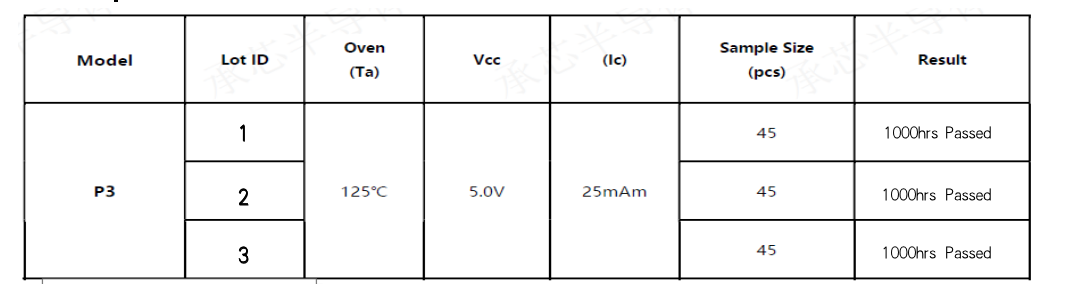
HAST-Highly Accelerated Stress Test
HAST指的是在高温高湿的环境下对器件进行加速老化测试,以模拟出长时间内所受到的环境应力,从而评估其可靠性和寿命,是目前可靠性测试中最常用的一种加速老化测试。
承芯HAST测试主要分为Device及Capacitor部分(参考JESD22-A118-B & JESD22-A110-E),结果如下:

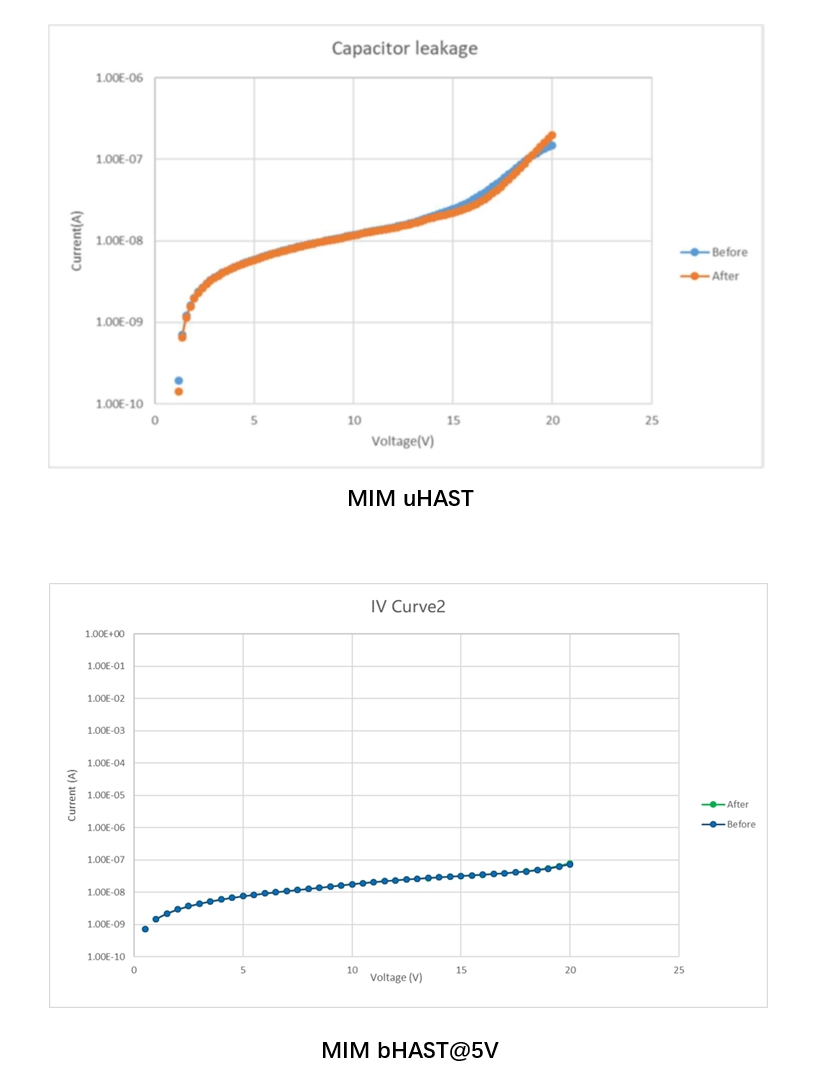
MTTF-Mean Time To Failure
MTTF一般指平均失效时间,指的是某个器件预计的可运行平均时间,在不可修复的系统中,指的是系统的平均寿命,即系统发生失效前的平均工作时间或工作次数,也成为系统在失效前的平均时间。
下图展示了承芯HBT工艺Ea值(Activation energy)为1.282eV,在125℃结温和20.8kA / cm2电流密度下平均失效时间为1.88E8 hrs。(参考JEP118A)
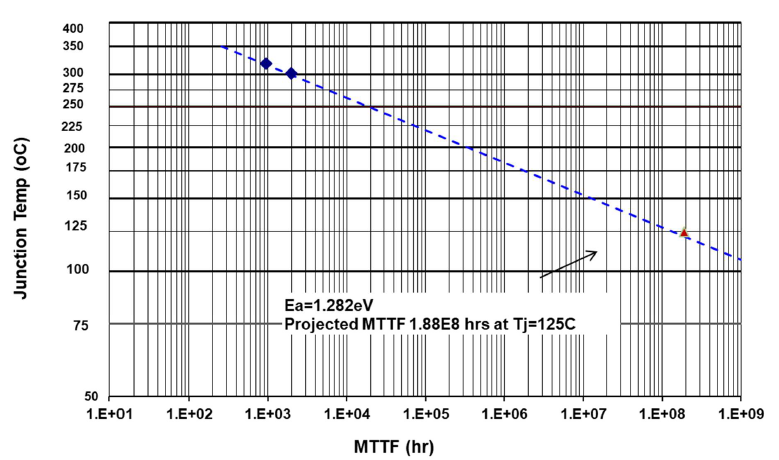
TDDB-Time Dependent Dielectric Breakdown
TDDB是一种与时间相关的电介质击穿,又叫经时击穿。
承芯使用600A电容介质厚度进行测试,在5V的运行电压下,达到最低限度1E + 6hrs要求(参考JESD92),测试结果如下:

结束语
以上是承芯HBT工艺在晶圆级别通过的可靠性测试,相信大家已经对承芯HBT工艺的可靠性有了基本的了解。承芯半导体拥有成熟的砷化镓代工工艺和滤波器设计、生产制造、销售能力,致力于发展中国大陆射频前端技术产业链。






